삼성전자, 엔비디아 AI 추론칩 생산 맡는다…젠슨 황 “삼성에 감사”
- 엔비디아 GTC 기조연설서 삼성 파운드리 역할 직접 언급
- AI 추론칩 ‘그록3 LPU’ 올해 3분기 출하 예정
- HBM4·HBM4E 공개하며 메모리·파운드리 협력 동시 부각
엔비디아 최고경영자(CEO) 젠슨 황이 삼성전자와의 반도체 협력을 공개적으로 언급하며 감사를 표했다. 차세대 인공지능(AI) 칩 생산에서 삼성 파운드리가 핵심 역할을 맡고 있다는 사실이 공식 확인되면서 글로벌 AI 반도체 공급망에서 양사의 협력이 더욱 주목받고 있다.
황 CEO는 16일(현지시간) 미국 캘리포니아 새너제이에서 열린 GTC 2026 기조연설에서 “삼성이 우리를 위해 ‘그록3(Groq3) 언어처리장치(LPU)’ 칩을 제조하고 있다”며 “지금 가능한 한 최대한 빠르게 생산을 늘리고 있다. 삼성에게 정말 감사드린다”고 말했다.
그록3 LPU는 AI 모델의 추론 성능을 강화하기 위해 설계된 전용 반도체다. 학습 중심의 GPU와 달리 실제 서비스 단계에서 대규모 연산을 빠르게 처리하는 데 특화된 칩으로, 차세대 AI 인프라에서 핵심 역할을 할 것으로 평가된다. 해당 칩은 엔비디아의 차세대 AI 플랫폼인 ‘베라 루빈’ 시스템에 탑재될 예정이며 올해 하반기, 빠르면 3분기부터 출하가 시작될 전망이다.
황 CEO의 발언을 통해 삼성전자의 파운드리 사업부가 이 칩 생산에 참여하고 있음이 공개되면서, 삼성은 메모리뿐 아니라 AI 시스템용 로직 반도체 생산에서도 엔비디아와 협력 관계를 확대하고 있는 것으로 분석된다. 그동안 AI 반도체 시장에서 삼성전자는 GPU용 고대역폭메모리(HBM) 공급을 중심으로 협력을 이어왔는데, 이번에는 파운드리 영역까지 협력 범위가 넓어진 셈이다.
삼성전자 역시 이번 행사에서 AI 반도체 생태계에서의 역할을 적극적으로 강조했다. 행사장 전시를 통해 차세대 고대역폭메모리인 HBM4E 실물 칩과 적층용 ‘코어 다이’ 웨이퍼를 처음 공개하며 AI 서버용 메모리 기술 경쟁력을 부각했다.
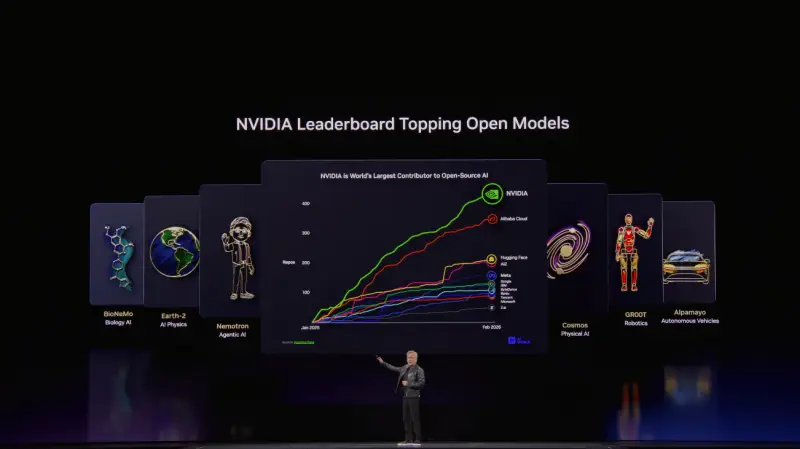
HBM4E는 핀당 16Gbps 전송 속도와 최대 4.0TB/s 대역폭을 지원할 예정으로, 최근 양산을 시작한 6세대 HBM4의 13Gbps·3.3TB/s 성능을 넘어서는 차세대 제품이다. 삼성전자는 10나노급 6세대 D램 공정과 4나노 파운드리 기반 베이스 다이 설계 역량을 결합해 HBM4E 개발을 가속하고 있다고 설명했다.
특히 삼성전자는 메모리·파운드리·로직 설계·첨단 패키징을 모두 갖춘 종합반도체기업(IDM) 구조를 강조하며 AI 반도체 시대에 최적화된 통합 솔루션을 제공할 수 있다는 점을 내세웠다. 행사에서는 열 저항을 20% 개선하고 16단 이상 고적층을 지원하는 하이브리드 구리 접합(HCB) 패키징 기술도 공개됐다.
업계에서는 이번 GTC에서 드러난 협력 구조가 향후 AI 반도체 시장 경쟁 구도에 중요한 의미를 갖는 것으로 보고 있다. 현재 AI 메모리 시장에서는 SK하이닉스가 엔비디아의 주요 HBM 공급사로 자리 잡고 있지만, 삼성전자가 HBM4와 차세대 HBM4E 기술을 앞세워 공급망 확대에 나서면서 경쟁이 더욱 치열해질 전망이다.
또한 글로벌 AI 인프라 확장 속도가 빨라지면서 GPU뿐 아니라 추론 전용 칩, 고대역폭 메모리, 첨단 패키징 등 다양한 반도체 기술이 동시에 필요해지고 있어 메모리와 파운드리 역량을 모두 가진 기업의 전략적 가치가 높아지고 있다는 분석도 나온다.
한편 삼성전자 AI센터의 송용호 센터장은 GTC 행사 둘째 날 엔비디아 특별 초청 발표에 나서 AI 인프라 혁신을 지원하는 삼성 메모리의 ‘토털 솔루션’ 전략을 소개할 예정이다.
더 좋은 미래를 위한 콘텐츠 플랫폼 – <굿퓨처데일리>

